新闻动态
我们的产品出口到30多个国家
具备从概念到全过程的开发能力从设计到量产并实施,目前已获得30多项自主知识产权
在AI、自动驾驶、物联网、云计算等领域驱动下,半导体产业聚焦功能集成与小型化升级,“超越摩尔定律”成为发展核心方向,多芯片模块(MCM)与系统级封装(SiP)技术正是关键引擎,而**精密无尘烤箱、真空压力烤箱**为其工艺落地提供核心支撑。
传统片上系统(SoC)虽实现电子产品小型化,但特征尺寸缩小带来极高非经常性工程(NRE)成本与良率难题。MCM与SiP作为异构集成主流方案,凭借更高灵活性、更低成本及更快上市速度,推动行业从“SoC为中心”向“SiP为中心”范式转变。
SiP将不同半导体材料(Si、SiC、GaN等)、不同技术世代的芯片及无源元件、MEMS、光学元件集成于单一封装,适配QFN、BGA等标准封装形式,其组件固化、互连稳定性完全依赖精密烘烤与真空压力设备。MCM则聚焦紧密耦合子系统封装,与SiP共同构成复杂半导体产品的核心集成方案,二者均对温度控制、压力调节及无尘环境有严苛要求。
SiP技术迭代核心在于互连技术升级,垂直/水平电气互连高密度化(基板分辨率低至25μm,RDL技术达2μm),对固化工艺精度提出极致要求。**精密无尘烤箱**以±1℃精准控温及Class 100级无尘环境,保障芯片贴装、引线键合后的互连稳定性;**真空压力烤箱**则为扇出型晶圆级封装(FOWLP)、扇出型面板级封装(FOPLP)提供无气泡、无应力残留的固化环境,优化热传导效率。
在功率半导体领域,SiC、GaN宽禁带半导体封装依赖真空压力烤箱的高温均匀固化,保障功率模块可靠性;MEMS传感器封装中,精密无尘烤箱可解决应力敏感、杂质干扰等痛点,适配自动驾驶、智能家居需求;物联网设备的多组件共固化难题,亦通过设备分段控温、真空调节功能破解。
面对布线密度提升、热管理优化、异构组件共组装等行业挑战,我们的设备通过分区控温、定制化烘烤曲线、智能数据监控追溯功能,适配汽车、航空航天等高端领域的可靠性要求,助力AI与SiP的深度融合及智能制造升级。
在半导体封装工艺链中,烘烤固化是保障SiP、MCM可靠性的关键环节。基于对行业工艺需求的深度理解,精密无尘烤箱与真空压力烤箱已成为异构集成封装中的核心配套设备,全程支撑芯片贴装固化、互连稳定性控制及最终封装成型等关键工序的顺利推进。
SiP封装的异构集成特性,使其涵盖多种细分工艺场景,不同场景对烘烤固化设备的性能需求各有侧重,精密无尘烤箱与真空压力烤箱可针对性适配,保障全流程工艺稳定性:在SiP裸芯片与无源元件共组装场景中,芯片贴装后的底部填充固化是关键工序,需依托精密无尘烤箱Class 100级洁净环境,避免粉尘污染填充间隙,同时通过±1℃高精度控温与阶梯式升温曲线,确保填充胶均匀固化,既增强芯片与基板的结合强度,又规避温度冲击导致的芯片破损,适配不同技术世代(从65nm到14nm及以下)CMOS芯片的封装需求。

针对集成光学元件、MEMS器件的SiP封装场景,工艺对洁净度与应力控制的要求更为严苛——光学元件表面易受杂质影响透光性能,MEMS器件则对固化应力高度敏感。精密无尘烤箱通过全腔室无尘净化设计与均匀送风技术,在固化过程中减少气流扰动,避免杂质附着于光学元件表面;同时精准控制升温速率,将固化应力控制在合理范围,防止MEMS传感结构变形,保障SiP封装的多功能协同实现。
对于包含表面贴装(SMT)元件与裸芯片的混合集成SiP封装,不同组件的热膨胀系数差异易引发固化后翘曲问题。此时可通过精密无尘烤箱的分区控温功能,针对不同区域组件适配差异化温度参数,平衡热应力分布;若涉及塑封后固化工艺,真空压力烤箱可进一步发挥优势,通过精准压力调节消除塑封料内部气泡,提升封装体致密性,避免后期使用中因气泡导致的散热不良或互连失效,适配QFN、BGA等标准SiP封装形式的量产需求。
针对FOWLP、FOPLP等扇出型封装工艺,真空压力烤箱的无气泡固化能力成为核心支撑,通过精准调节腔内压力,消除封装过程中产生的气泡残留,同时优化热传导效率,适配大面积面板或晶圆级封装的均匀固化需求;在SiC、GaN等宽禁带功率半导体封装场景中,高温固化是保障模块可靠性的关键工艺,真空压力烤箱可实现高温环境下的精准控压与均匀加热,兼顾功率器件的耐高温需求与封装密封性,破解宽禁带半导体封装的热稳定性难题。这些设备的场景化适配,为各工艺环节提供稳定保障,成为支撑SiP、MCM技术规模化落地,推动“超越摩尔定律”演进的重要基础。
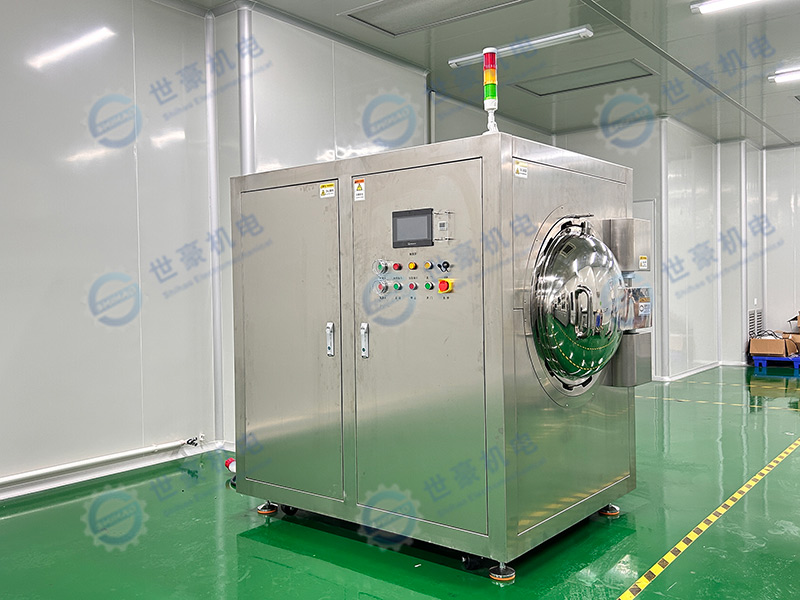
伴随半导体封装向更高密度、多元异构集成、高可靠性方向升级,烘烤固化设备也需同步迭代。未来,需持续深耕核心技术,强化设备在精准度、智能化、场景适配性上的表现,以更贴合产业需求的工艺配套能力,助力全球半导体封装产业的技术创新与生态构建。
拥有30多名资深工程师,苹果级别的制造标准和世界500强的严格认证